簡介:
近年來5G、AI等新興科技的興起 , 加上受到COVID-19疫情影響 , 伺服器產業受惠宅經濟及遠距工作需求 , 伺服器需求大增 , 而資料中心由許多伺服器所建構而成的 , 熱的處理及產品可靠度對設計者是一門重要課題。
英飛淩推出的首款頂部散熱表面貼裝器件(SMD)封裝,可滿足PC/Server/5G等高功率SMPS應用的需求。 利用現有高壓技術、低導通電阻600V CoolMOS™ G7 及CoolSiC™肖特基二極體650V G6優勢與頂部散熱的創新相結合,為功率因修正器(如PFC)及PWM DC/DC架構提供高效解決方案。
● 頂部散熱
基於SMD的SMPS設計支援快速開關切換,並有助於減少與長引腳封裝(例如常見的TO-220封裝)相關的寄生電感。 在當今基於SMD的設計中,輸出功率受PCB材料的熱限制,因為熱能必須通過電路板散熱。DDPAK的頂部散熱概念,可實現電路板和半導體的熱傳導,實現更高的功率密度或更長的系統壽命。
~ 可提升整體輸出功率約20%
基於DDPAK的SMD解決方案可在標準散熱規範的電路板溫度要求上,實現高出20%的輸出功率,或相同外形尺寸下實現更高的功率密度,達成產品小型化。
~ 約可降低12°C的電路板溫度
基於DDPAK的SMD解決方案可約降低電路板溫度12°C,藉而延長系統壽命。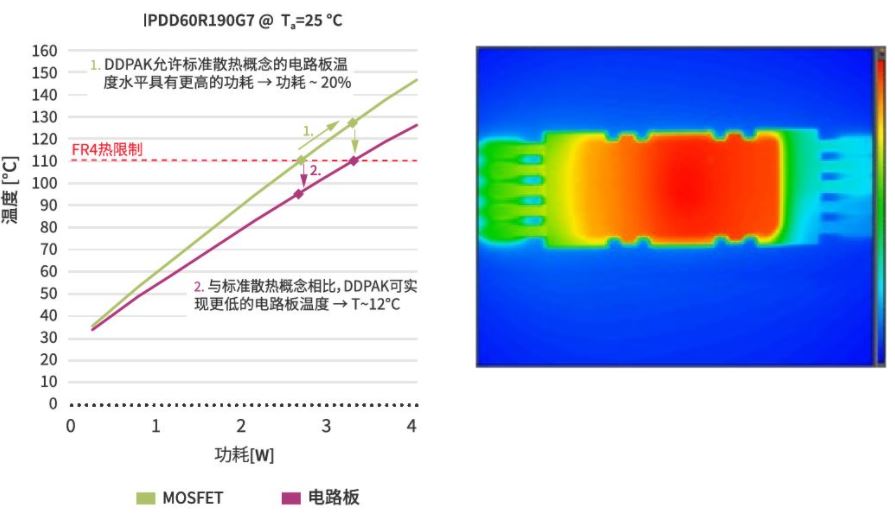
● 低寄生電感
DDPAK提供內置第4引腳具有非常低的寄生源極電感。 獨立的「源極」引腳為驅動器提供不受干擾的信號,因此提高了易用性水準。此第4引腳功能與英飛淩最新的SJ MOSFET 和 CoolSiC™肖特基二極體技術相結合,可確保最高的效率水準,並達到80 PLUS® Titanium標準。

● 主要特性主要特性與優點- DDPAK封裝
主要特性
- 創新的頂部散熱理念
- 內置第4源極接腳和低寄生電感
- 符合MSL1標準,完全無鉛
主要優勢
- 解決電路板和半導體PCB的熱限制
- 減少寄生電感,提高整體效率
- 實現更高的功率密度解決方案
● 採用DDPAK封裝的CoolMOS™ G7和CoolSiC™ G6
採用DDPAK封裝的CoolMOS™ G7
- 具有一流的 FOM RDS(on)x Eoss 和 RDS(on) x Qg
- 實現最高的電源效率

採用DDPAK封裝的CoolSiC™ G6
- 提供一流的VF和VF 和 FOM Qc x VF
- 提高的dv/dt穩定度
- 便捷有效地匹配CoolMOS™7 SJ MOSFET系列
- 實現最高的能源效率

參考於Infineon官網
評論