在半導體製造領域,電氣過應力(EOS)和靜電放電(ESD)是導致晶片失效的兩大主要因素,約占現場失效元件總數的50%。它們不僅直接造成元件損壞,還會引發長期性能衰退和可靠性問題,對生產效率與產品品質構成嚴重威脅。
ESD(靜電放電)即靜電放電,指物體因接觸摩擦累積電荷後,與導體接近或接觸時發生的瞬間電子轉移現象。放電電壓可達數千伏,能直接擊穿敏感的半導體結構。
其產生方式主要包括:人體放電模型(HBM)——人體靜電經由晶片引腳放電;機器放電模型(MM)——自動化設備累積靜電傳導至晶片;元件充電模型(CDM)——帶電晶片引腳接觸接地體時內部電荷釋放;電場感應模型(FIM)——外部電場變化引發晶片內部電荷重新分佈。
ESD
ESD的危害具有多重性:第一,直接造成晶體管擊穿、金屬連線斷裂等物理損壞;第二,引發閾值電壓漂移等參數退化,導致性能不穩定;第三,形成微觀損傷,降低元件的長期可靠性;第四,導致資料遺失或誤操作,威脅系統安全。其隱蔽性和隨機性進一步增加了防控的難度。
關於ESD的防護需要採取綜合措施:
耗散:使用表面電阻為10⁵–10¹¹Ω的防靜電工作墊、地板等材料;
泄放:透過接地導線、防靜電手環/服裝/鞋子實現人員與設備接地;
中和:在難以接地的區域採用離子風機中和電荷;
屏蔽:利用法拉第籠原理對靜電源或產品進行主動/被動屏蔽;
增濕:提高環境濕度作為輔助手段;
電路設計:在敏感元件中整合防靜電電路,但需注意其防護能力有一定的上限。
EOS
EOS(電氣過應力)是指晶片承受的電壓或電流超過其耐受極限,通常由持續數微秒至數秒的過載引發。主要誘因包括:電源電壓瞬變(如浪湧、紋波)、測試程序熱切換導致的瞬態電流、雷電耦合、電磁干擾(EMI)、接地點反跳(接地不足引發高壓)、測試設計缺陷(如上電時序錯誤)及其他設備脈衝干擾。
EOS的失效特徵為熱損傷主要原因:過載電流在局部產生高熱,導致金屬連線大面積熔融、封裝體碳化焦糊,甚至金/銅鍵合線燒毀。即使未造成物理破壞,也可能因熱效應誘發材料特性衰退,表現為參數漂移或功能異常。更嚴重的是,EOS損傷會顯著降低晶片的長期可靠性,增加後期故障率。
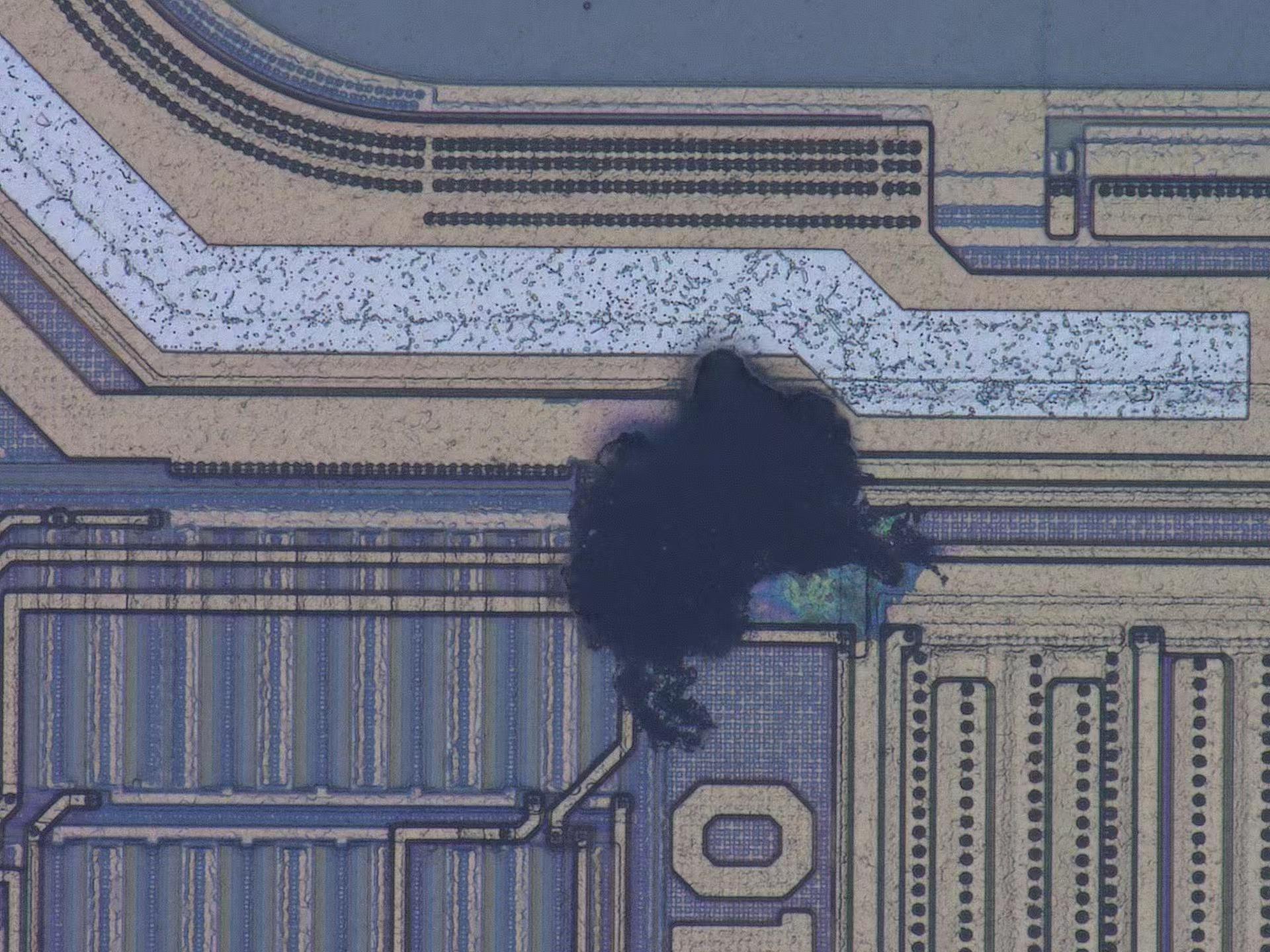
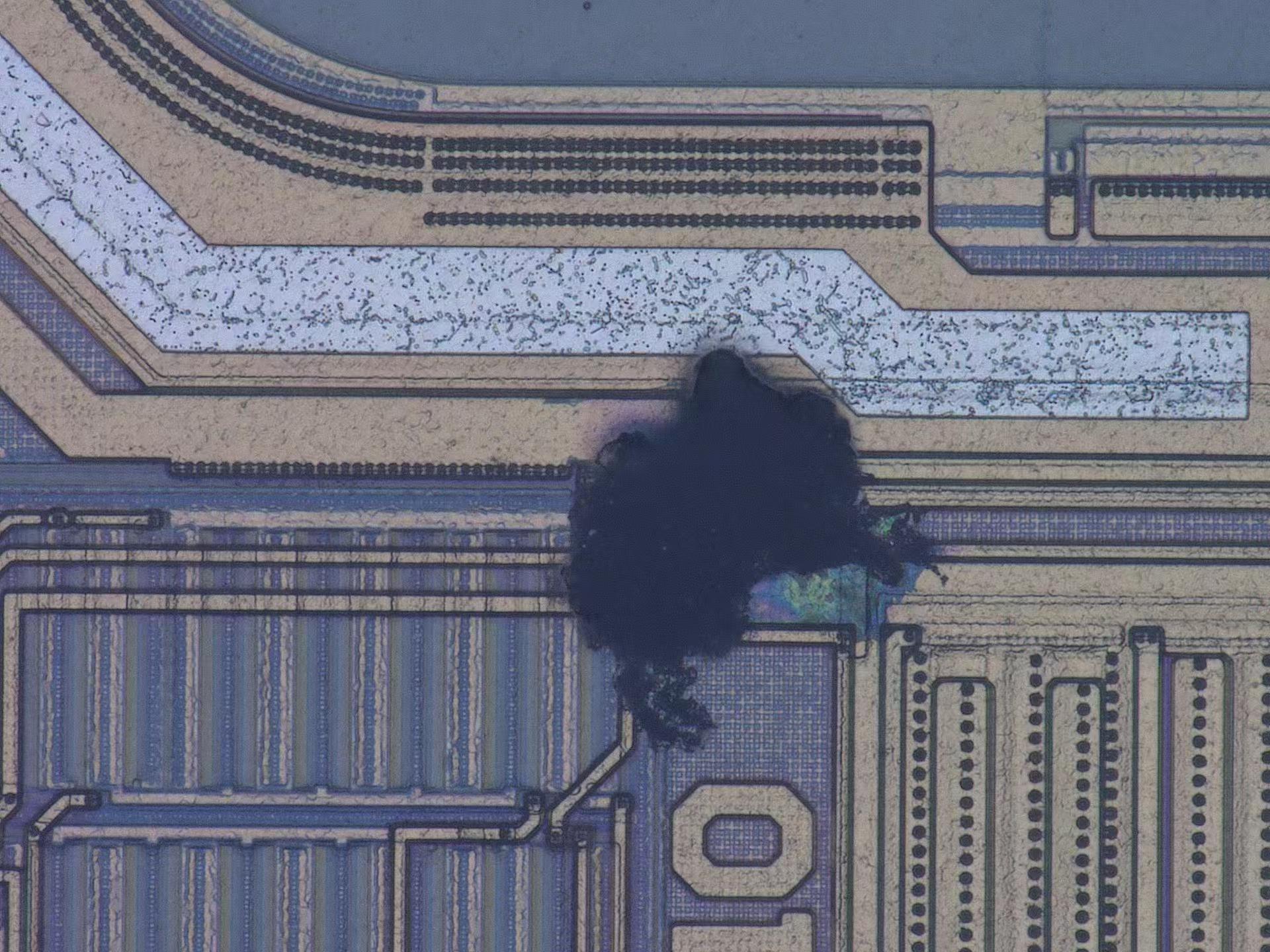
EOS防護的核心是限制能量注入:
阻容抑制:串聯電阻限制進入晶片的能量;
TVS 二極管:並聯瞬態電壓抑制器可疏導過壓能量,建議搭配電阻使用以分擔浪湧衝擊。
材料防護:採用靜電屏蔽包裝和抗靜電材料;
工作環境:使用防脈衝干擾的安全工作台,定期檢查無靜電材料污染;
設計加固:優化晶片耐壓結構及佈局走線,減少電磁干擾影響。
參考來源